Технологии производства микроактюаторов.
В настоящее время существует несколько базовых технологий производства микроактюаторов, точнее технологий производства МЭМС (микроэлектромеханических устройств) составной частью которых, в том числе, являются микроактюаторы. Это технология объёмной микрообработки, поверхностной микрообработки, LIGA и SIGA технологии, а также MUMPs процесс.
Кремниевая объёмная микрообработка.
Под кремниевой объёмной микрообработкой понимают технологию глубинного объёмного травления, при чём травление может быть как жидкое химическое анизотропное, так и плазменное.
Сухое травление.
Сухое травление - это метод силиктивного удаления не маскированных участков поверхности. Особенности процесса заключаются в том, что этот процесс можно комбинировать с технологией тонких плёнок и с технологией КМОП. Также посредством физико-химического травления контролируется профиль травления.
Параметры процесса | Преимущества | Недостатки |
1.Параметры плазмы:
состав газа
напряжение смещения
температура подложки
плотность плазмы
давление процесса | 1.Осмысленно получаемое горизонтальное изображение. | 1.Обработка пластин по отдельности. |
2. Маскирование полимерами и тонкими плёнками:
- термически SiO,
- химическим осаждением из паровой фазы при пониженном давлении SiO2 или Si3N4
-нанесение фоторезиста
- металлизация (Cr, Al).
| 2.Изменяемый профиль | 2.Увеличение времени травления. |
3. Химическое воздействие:
с обратной стороны (мембраны, отверстия)
-геометрическая форма определяется шаблоном маски,
с передней стороны (консоли, каналы, затворы)
- геометрическая форма определяется подтравливанием.
| 3.Возможно получение рельефных изображений | 3.Нет собственного ограничителя травления и определения изображения |
4.Газы травителя:
SF6 - CBrF3 при t< 270K
SF6 - O2 при t< 100 K
CHF3 - O2 при t< 100 K
CHCl3 при t< 270 K. | | |
Жидкое химическое анизотропное травление.
В этом процессе используется то, что разные кристаллографические направления кристалла травятся с разной скоростью (остаётся поверхность с ориентацией 111).
Параметры процесса | Преимущества | Недостатки |
1. Ориентация подложки:
111(канавка V-образного сечения)
110(канавка U-образного сечения, не стандартизована) | 1. Простой процесс группового изготовления. | 1. Маскирование для глубинного травления. |
2. Маскирование тонкими плёнками:
- термически SiO2,
- химическим осаждением из паровой фазы при пониженном давлении SiO2 или Si3N4
- металлизация (Cr) для термомеханической обработки.
| | 2. Ограниченный набор получаемых изображений. |
3. Химическое воздействие:
с обратной стороны (мембраны, каналы)
- геометрическая форма определяется кристаллографическими плоскостями,
с передней стороны (консоли, каналы)
- геометрическая форма определяется подтравливанием.
| | 3. Проблемы с внешними углами. |
| 4. Процесс группового изготовления ограничен поверхностной реакцией. | | |
Подробно этапы жидкого химического анизотропного травления представлены на рисунке.
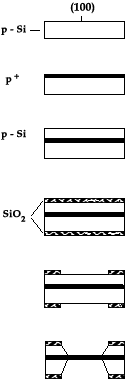 |
1. (100 - подложка)
2. p + легирование для получения слоя остановки травителя
3. осаждение эпитаксиального слоя
4. окисление
5. литография и травление SiO2
6. анизотропное травление
|
Кремниевая поверхностная микрообработка.
Главной особенностью этой технологии является то, что она совместима с полупроводниковой технологией, для микрообработки используется КМОП технология.
Параметры процесса | Преимущества | Недостатки |
| 1. Плазмохимическое осаждение из паровой фазы или химическое осаждение из паровой фазы при пониженном давлении поликристаллического кремния, фосфорокварцевого стекла. | 1. Осмысленно получаемаягоризонтальная геометрическая форма | 1. Уменьшенное отношение ширины канала к длине
|
2. Маскирование полимерами и тонкими плёнками:
- нанесение фоторезиста
- термически SiO2
- химическим осаждением из паровой фазы при пониженном давлении SiO2 или Si3N4 фосфорокварцевого стекла.
| 2. Изменяемый профиль | Сокращение количества материалов |
| 3. Сухое и жидкое термическое окисление. | 3. Есть возможность получать свободные структуры | | | 4. Геометрическая форма определяется маскированием и при травлении. | 4. Совместимость с КМОП. |
|
| 5. Травление (сухое и жидкое) | |
|
Подробно этапы кремниевой поверхностной микрообработки представлены на рисунке.
 | 1. Осаждение изолирующего слоя и основы из поликристаллического кремния.
2. Осаждение 1-го жертвенного слоя и формирование исходного рисунка.
3. Осаждение поликристаллического кремния и формирование изображения рисунка статора и ротора
4. Нанесение рисунка на 1-ый жертвенный слой и на 2-ой жертвенный слой
5. Травление жертвенных слоёв и освобождение ротора
|
LIGA технология.
Технология разработана в Германии примерно 30 лет назад. Аббревиатура означает - рентгенолитография, гальваника и формовка. Сущность процесса заключается в использовании рентгеновского излучения от синхротрона для получения глубоких, с отвесными стенками топологических картин в полимерном материале. Излучение синхротрона имеет сверхмалый угол расходимости пучка. Источником излучения являются высокоэнергетические электроны (энергия Е>1ГэВ) движущиеся с релятивистскими скоростями. Глубина проникновения излучения достигает единиц миллиметров. Это обуславливает высокую эффективность экспонирования при малых временных затратах.
Параметры процесса | Преимущества | Недостатки |
1. Рентгенолитография (синхротрон) в полиметилметакрилате
0 < d < 2 мм. | 1. Имеет наилучшее отношение ширины канала к длине при минимальных размерах | 1. Ограничена возможность комбинирования с полупроводниковой технологией (КМОП).
|
| 2. Гальваника.
| 2. Структуры с высоким разрешением топографического изображения. | 2. Есть ограничения на форму рельефа и на получение свободно перемещаемых структур. |
| 3.Дочерняя и большая дочерняя копия из полимеров или металла. | 3. Жёсткий допуск. | 3. Ограничена точность по высоте. | | | 4. Возможно получение свободно перемещаемых структур. | 4. Высокая сложность изготовления
|
| | 5. Разнообразие материалов. | 5. Чрезвычайно дорогие маски и экспонирование
| Подробно этапы LIGA технологии представлены на рисунке.
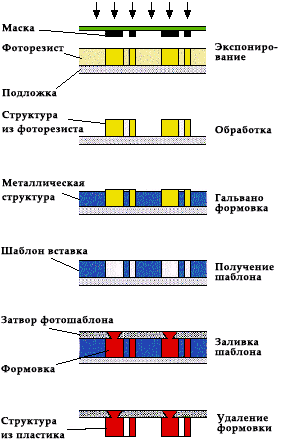 SIGA технология.Аббревиатура означает - ультрафиолетовая литография, гальваника и формовка. Из особенностей этого процесса можно отметить, что можно управлять шириной профиля и то, что технология совместима с технологией тонких плёнок.
Параметры процесса | Преимущества | Недостатки |
| 1.Ультрафиолетовая литография фоторезиста. | 1. Хорошее разрешение топографического изображения | 1. Ограничена точность по высоте (КМОП).
|
| 2. Осаждение слоёв и плазменное травление.
| 2.Низкий допуск | 2. Есть ограничение для высоких структур |
| 3. Гальваника | 3. Высокое отношение ширины канала к длине. | 3. Ограничена скорость травления | | 4. Дочерняя и большая дочерняя копия из полимеров или металла. | 4. Возможно получение свободно перемещаемых структур. | 4. Обработка подложек только по отдельности
|
| | 5. Разнообразие материалов. |
|
|
| 6. Уменьшены работы по производству | |
|
| 7. Возможно получение рельефных изображений | |
|
| 8. Совместима с кремниевой технологией. | | Подробно этапы SIGA технологии представлены на рисунке.
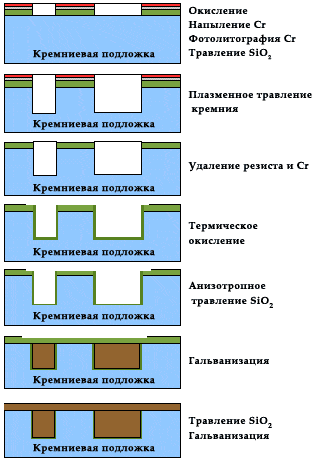 MUMPs.MUMPs - аббревиатура означает многопользовательская МЭМС технология - это очень известная коммерческая программа, которая предоставляет разработчику рентабельный доступ к поверхностной механической обработке. Эта программа, предлагаемая исключительно Cronos, предназначена для предоставления универсальной микрообработки разным пользователям, которые желают проектировать и изготовлять MEMS устройства. Она начала использоваться в декабре 1992 года. Этот процесс, можно сказать, трамплин, для того чтобы проектировать и проверять опытные образцы МЭМС устройств и ускорять процессы развития изделия. MUMPs - это процесс 3-х слойной поликристаллической поверхностной микрообработки. Подробно этапы MUMPs представлены на рисунке.
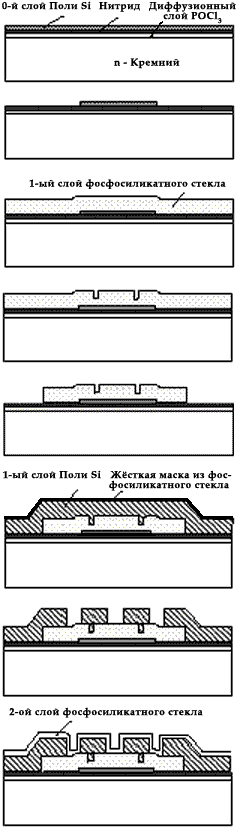 |
1. Cильное легирование фосфором
2. Осаждение нитрида кремния (0,5 мкм)
3. Осаждение поликремния (0,5 мкм) при низком давлении и отжиг
4. Нанесение изображения на 0-ой слой Поли Si при помощи реактивного ионного травления
5. Осаждение 1-го слоя фосфосиликатного стекла (2мкм)
6. Получение изображения углублений (глубина 0,75 мкм) при помощи реактивного ионного травления
7. Получение изображения контактного окна к слою Поли Si / Нитрида (2 мкм) при помощи реактивного ионного травления
8. Осаждение 1-го слоя поликремния
(2мкм)
9. Осаждение маски из фосфосиликатного стекла (0,2 мкм)
10.Отжиг при температуре 1050 0C
11. Вытравливание маски из фосфосиликатного стекла при помощи реактивного ионного травления
12. Нанесение изображения на 1-ый слой Поли Si при помощи реактивного ионного травления
13. Осаждение 2-го слоя фосфосиликатного стекла.(0,5 мкм) |
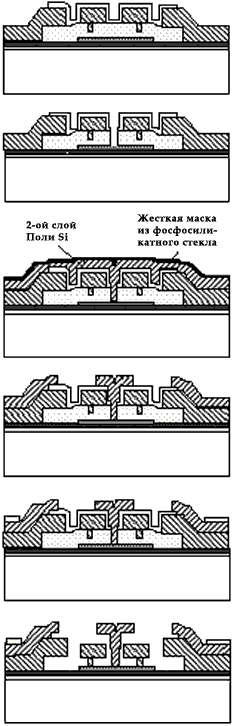 |
14. Получение изображения контактного окна к 1-му слою Поли Si при помощи реактивного ионного травления.
15. Получение изображения контактного окна к 0-му слою Поли Si/Нитриду при помощи реактивного ионного травления
16. Осаждение 2-го слоя Поли Si (1,5 мкм).
17. Осаждение маски из фосфосиликатного стекла (0,2 мкм).
18. Вытравливание маски из фосфосиликатного стекла при помощи реактивного ионного травления
19. Нанесение изображения на 2-ой слой Поли Si при помощи реактивного ионного травления.
20. Осаждение слоя металла (0,5 мкм).
21. Частичное снятие металлического слоя.
22. Внесение в концентрат HF на 2,5 минуты для получения окончательной структуры. |
Также вы можете загрузить MUMPs.ppt- это презентация технологии MUMPs от Cronos. |
| Раздел Технологии производства микроактюаторов составлен с использованием учебных материалов Дж. Мюллера и официального сайта Cronos. [4,7]
|
|